影响BGA返修的主要因素 点击:92 | 回复:0
发表于:2020-09-23 17:35:08
楼主
现在采用BGA封装的产品有很多种,如常见的电脑显卡、南北桥、CPU,在手机、投影仪、电视等产品中也有BGA元器件。主要因素可划分为三点:
一、防止PCB变形;
二、精准的温度控制;
三、贴装的精度;
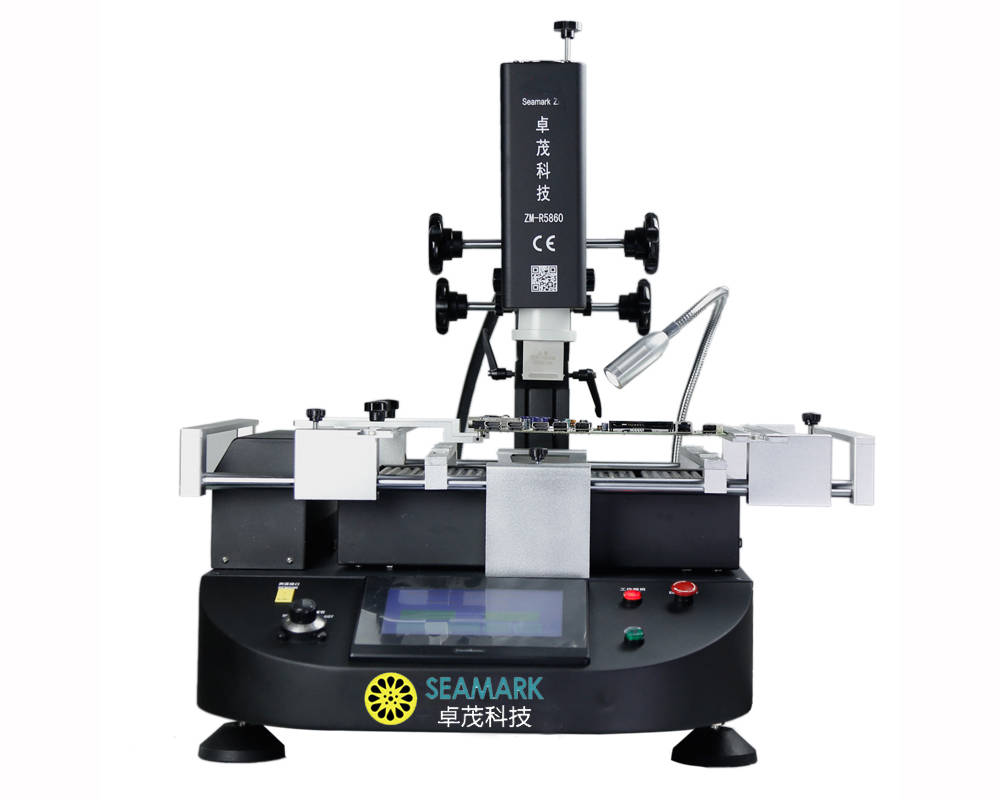
除此之外还有其他影响BGA返修质量的因素,如下:
1.已经开封后的BGA元器件如果没有放置在防潮柜内的话,需要对BGA进行烘烤预热(时间为8~20小时,温度为80~100℃)。防止BGA在迅速受热时发生崩裂。同样PCB也需要进行一定程度的预热。
2.在焊接锡球的时候,需要保证锡球的质量。避免使用已经氧化的锡球或者沾染上其他杂质的锡球。工业生产中,一般刷锡膏的话还需要注意锡膏的搅拌,回温等问题。
3.焊接时,在PCB板上需要刷上均匀、适量的助焊膏,过多的话容易造成短路。
4.有铅锡球的流动性、焊接性能较好,但是不环保。目前只有在军工领域才会采用有铅,一般情况下选择无铅返修。
5.焊接时注意BGA周边的元器件,尽量使用风嘴,防止加热到其它元器件,元器件比较密集的更需要注意,像手机上就比较密集了。
6.有一些BGA元器件上会采用灌胶的方式固定,这时候通常采用的方式就是持续加热,然后把胶体撬开。
7.拆焊结束,移动BGA元器件时请最好使用真空吸笔,避免使用金属镊子,这样可能会损伤芯片。
8.避免用力按压BGA元器件,防止BGA损伤或裂纹。
一般情况下光看外表无法检验出BGA是否焊接好,需要借用一定的设备才可以检验。但是避免那些可能导致失败的因素,可以有效的提高成功率。
楼主最近还看过
热门招聘
相关主题
- 咸庆信老师变频器维修培训班...
 [5584]
[5584] - 三菱plc发脉冲后安川伺服电机...
 [3963]
[3963] - 东芝伺服报警AL-32请教
 [3025]
[3025] - 西门子Smart700IEV3系列进不...
 [1150]
[1150] - ABB变频器ACS880报5681故障如...
 [5019]
[5019] - 安川676H5变频器CPF21故障修...
 [1328]
[1328] - 关于空压机改变频后,启动偶尔...
 [1736]
[1736] - 自耦变压器降压启动启动电流...
 [3438]
[3438] - 现场维修科陆CL2700高压变频...
 [1584]
[1584] - 数字电流电压表的使用注意事...
 [1718]
[1718]

官方公众号

智造工程师
-

 客服
客服

-

 小程序
小程序

-

 公众号
公众号

















 工控网智造工程师好文精选
工控网智造工程师好文精选
