福英达浅谈MEMS封装焊接技术 点击:86 | 回复:0
福英达浅谈MEMS封装焊接技术
1. MEMS封装介绍
MEMS是将微传感器,微执行器,信号处理,电路等元件连接在一起的系统,目前主要用于各类传感器。在对IC封装进行长时间的研究后,人们决定将IC封装理论的实践延伸到MEMS中。尽管许多MEMS封装形式是IC封装的延伸,MEMS的高度复杂性加大了封装难度和成本。通常来说MEMS封装成本占到了总设备费用的一半或更高,是因为MEMS的独特性导致没有标准的封装技术。传统的IC封装需要提供芯片管脚的合理分布并且能够实现电气连通。不同的是由于MEMS应用场景的不同,封装外壳需要为各种能量和介质的流通提供通道,例如光信号,电信号,流体成分等的流通,这加大了封装难度。
2. MEMS封装要求
由于要接收外界信号和介质,MEMS不可避免要与外界接触。由于体积太小且封装外壳需要与外界保持连通,应用环境中的杂质会腐蚀元件并影响可靠性。另外封装时产生的震动,冲击,温度变化会影响机械结构脆弱的元件可靠性和性能。为减少对敏感高精度传感器的影响,焊接受到的应力应控制在尽量小的范围。内部电路系统需要有效与外部环境隔绝开来。MEMS往往是不可拆卸清洗的,因此需要焊接点挥发物保持在低量范围。过量的挥发残留物会影响元件的可靠性。
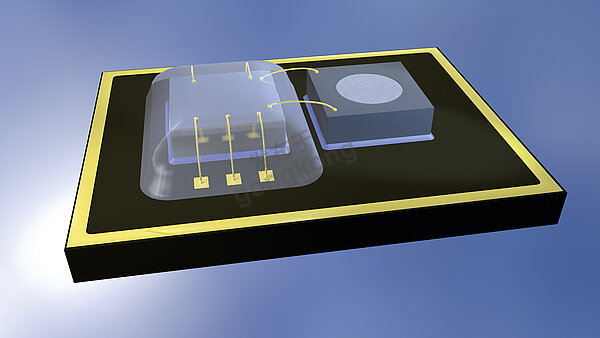
3. MEMS封装工艺
相比于常用的引线键合,目前还探索了新型的倒装封装技术。倒装芯片顾名思义就是将芯片倒装焊接在基板上的技术,其优点是大大增加了I/O的数量。相比引线键合,倒装技术避免了引线产生的信号干扰。单芯片/多芯片封装和晶圆级(WLP)很好的应用了该技术。为了使元件保持高精度,封装焊接通常是在真空下完成。
① 单芯片/多芯片封装
芯片级封装是将芯片从大块晶圆中取出后进行封装。主要采用陶瓷或玻璃基板进行封装。MEMS芯片和陶瓷基板的工艺不同导致了它们需要单独加工。MEMS芯片通过贴片,引线键合或直接倒装与基板连接,然后将芯片与陶瓷基板相焊接并进行封帽处理。常见的封帽材料有金属,陶瓷等。封帽的主要目的时能给芯片带来高气密性和可靠性。
② 晶圆级封装。
晶圆级封装是在还未进行切割的大块晶圆上直接进行封装的技术。需要对晶圆钝化层进行聚合物涂覆,对铜焊区域线层重新排布后进行第二层聚合物涂覆,加入球下金属层,并进行植球。进行封装测试后将大块完整晶圆进行切割取出单个的成品芯片,随后芯片在经过性能检测后被倒装焊在基板上,其中需要使用锡膏/锡胶进行粘连焊接。芯片最后通过多种键合工艺与封帽形成互连结构。
目前两种封装线路仍存在缺陷,但是晶圆级封装随着技术的演变无疑是MEMS封装的主流线路,不同厂家逐渐开发出不同晶圆级封装的分支路线。
楼主最近还看过

官方公众号

智造工程师
-

 客服
客服

-

 小程序
小程序

-

 公众号
公众号

















 工控网智造工程师好文精选
工控网智造工程师好文精选
